Elektronik- und Halbleitermodulprüfung E-LIT
Modularer automatisierter Prüfstand
Analyse von Elektronik- und Halbleiterbauelementen
Modularer Messplatz für Online Lock-In-Messungen
Temperaturmessung und Erkennung von thermischen Auffälligkeiten im mK- und μK-Bereich
Lokalisierung von Punkt- und Linienkurzschlüsse, Oxidations-Defekten sowie Transistor- und Diodenfehlern in mehrlagigen Leiterplatten und Multi-Chip-Modulen
Erkennung von „Wasserzeichen“ und thermischen Signaturen zur Prüfung der Echtheit
Nutzung von Thermografiesystemen mit gekühlten und ungekühlten Detektoren
Bediensoftware IRBIS® 3 active mit umfangreichen Analysemöglichkeiten

Lock-In Testmessung in Echtzeit mit E-LIT von InfraTec

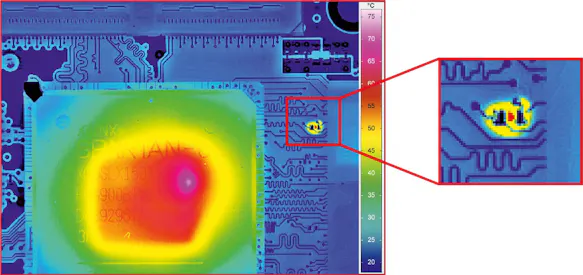
E-LIT – Lock-In Thermografie für die Elektronik – ist ein automatisiertes Prüfsystem innerhalb der zerstörungsfreien Prüfung. Es erlaubt eine berührungslose Fehlerinspektion an sowie die Kontrolle der Echtheit von Halbleitermaterialien, elektronischen Bauteilen und elektronischen Schaltungen. Ungleichmäßige Temperaturverteilungen und lokale Energieverluste können mittels des speziellen Lock-In-Verfahrens und einer leistungsfähigen Thermografiekamera in kürzesten Prüfzeiten detektiert werden.
Die elektrische Anregung für den Halbleitertest wird aus dem System parametriert und direkt synchron angesteuert. Sogar Fehler, die lediglich mK- oder μK-Abweichungen hervorrufen, können detektiert werden.
Kleinste Defekte, wie Punkt- und Linienkurzschlüsse, Oxidations-, Transistor- und Diodenfehler auf einer Leiterplattenoberfläche sowie in Schaltkreisen können exakt zweidimensional erkannt und dargestellt werden. Durch eine Veränderung der Lock-In-Frequenz lassen sich Fehler in Stacked-Die-Packages oder Multi-Chip-Modulen sogar räumlich zuordnen. In Verbindung mit einer Algorithmus-gestützten Mustererkennung lassen sich auch Manipulationen an den Schaltkreisen detektieren.
Die leistungsstarke Lock-in-Thermografie-Software verwendet für diese und ähnliche Aufgaben Algorithmen und Routinen aus den neuesten wissenschaftlichen Veröffentlichungen.
E-LIT nutzt zur Auflösung kleinster geometrischer Strukturen Hochleistungs-Mikroskopobjektive und SIL-Linsen. Mittels hochauflösender Detektoren bis zu (2.560 x 2.048) IR-Pixel können auch Mikrodefekte erkannt und charakterisiert werden.
Prüfung von Elektronik- und Halbleitermodulen mittels Lock-In-Thermografie
Erfahren Sie in unserem Whitepaper, wie Sie mittels Lock-In-Thermografie Fehlern in Elektronik- und Halbleiterbauteilen auf die Spur kommen. Profitieren Sie von unseren Praxistipps und erzielen Sie bestmögliche Messergebnisse mit dem E-LIT-Prüfstand von InfraTec.

Vorteile des modularen Prüfstandes
Messung mit einem Messplatz: Fehleranalyse von Schaltkreisen von der ganzen Platine bis ins kleinste Detail
Kundenspezifischer modularer Messplatz, z. B. mit X-Y Tisch und Z-Achse manuell oder motorisch einstellbar, zur Positionierung und individuellen Einstellung der Arbeitsabstände, abhängig von der Messobjektgröße des Prüflings
Flexibilität durch variable Komponenten, z. B. verschiedene Optiken, Aufnahmeeinrichtungen für den Prüfling oder Kontaktierungsmöglichkeiten
Echtzeit Lock-In-Messung mit höchster Empfindlichkeit
Vollständige und präzise mikroskopische Analyse
Geometrische Auflösung bis zu 1,3 μm mit Mikroskopobjektiven
Thermische Auflösung im Mikrokelvinbereich
High-Voltage Prüfplatz mit zwangsläufigem Berührungsschutz und Betriebszustandsmeldeleuchte
Einbindung von High-voltage Source-Meter-Unit bis 3 kV
Integrierter IV-curve tracer für i-v characterization
Mehrschichten-Analyse
Automatische Abrasterung größerer Proben über Präzisionsmechanik

Erkennung und Zuordnung der Position von Defekten im µK-Bereich
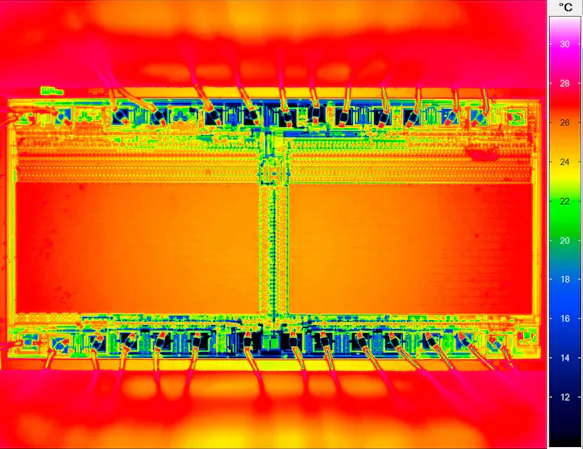
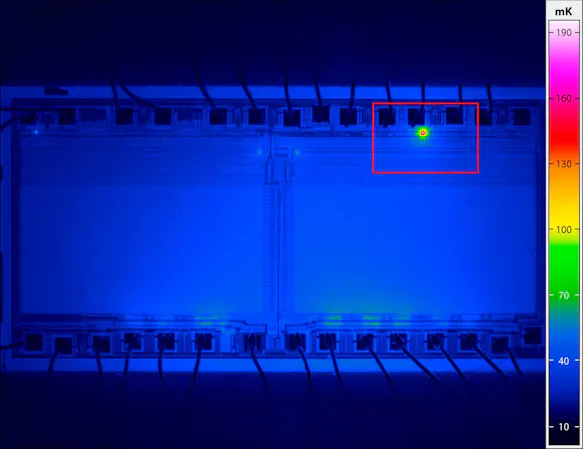

Online-Events on demand: Elektronik- und Halbleitermodulprüfung
Infrared Lock-in Thermography for Inspection of Electronics and Integrated Circuits
Fehleranalyse und Fehlerprüfung, Qualitäts- und Prozesskontrolle sowie flexible F&E-Lösungen
Hotspot-Erkennung auf Leiterplatten, integrierten Schaltkreisen, Halbleitermaterialien und Multi-Chip-Modulen
Erkennung fehlerhafter thermischer Verbindungen von Kühlkörpern, Kurzschlüssen, Lötfehlern und Drahtbondfehlern
Ergänzender Fachvortrag Semiconductor IR-LIT Analytics – Challenges and Case Studies von Marko Hoffmann; Infineon Technologies Dresden GmbH & Co. KG

Thermografie für die industrielle Automation
Effiziente Qualitätskontrolle durch schnelle, berührungslose Temperaturmessung während der laufenden Produktion
Flexible Systemlösungen von modularen Komponenten bis hin zu vollständig kundenspezifischen schlüsselfertigen Anlagen
Integrierte Software für die automatisierte Auswertung, Dokumentation und Auslösung von Folgeprozessen

Aufnahmen von Thermografiebildern mit verschiedenen Objektiven
100 mm Teleobjektiv
Mikroskopobjektiv 3×
Mikroskopobjektiv 1×

Möchten Sie mehr erfahren?
Nicht selten sind Aufgabenstellungen mit besonderen Anforderungen verknüpft. Besprechen Sie gemeinsam mit unseren Spezialisten Ihre konkrete Anwendung, erhalten Sie weiterführende technische Informationen oder lernen Sie unsere Zusatzdienstleistungen kennen.
Thermografiesoftware IRBIS® 3 active
Bediensoftware mit umfangreichen Analysemöglichkeiten unter Laborbedingungen
Optionale Zusatzsoftware zur parametergesteuerten automatischen Fehlerklassifizierung
Einfache Handhabung mittels intuitivem Benutzerinterface
Darstellung verschiedener Zustände des Messobjektes in Echtzeit
Vielfältige Speichermöglichkeiten für Bilddaten und Messergebnisse
Darstellung der komplexen Intensitätsinformation als 0°-Bild, 90°-Bild oder mit frei wählbarem Phasenwinkel
Bildüberlagerung von Live- und Amplitudenbild
Optional: IV-Messung, Undersampling, Driftkompensation, Verlustleistungsmessung, Nutzer- und Rezeptverwaltung, verschiedene Schnittstellen zu anderen Systemen
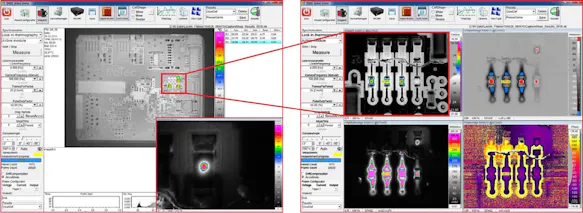
Produktflyer
Erhalten Sie alle Informationen auf einen Blick in unseren Produktflyern